

晶圆键合 | 晶圆减薄 | 芯片划片 | MPW切割 | 芯片挑粒
英创力科技于2019年4月在江苏投资设立了全资自营制造基地,致力于半导体晶圆及器件的加工及制造等业务,核心管理层的半导体从业经验累计超过100年!
制造基地位于半导体产业链聚集的长三角地区的旅游名城江苏省无锡市,通过厂区联用、自购设备部署以及同业协作等灵活、创新的制造模式,公司分别在无锡、苏州等地区建立了3处自营制造厂区,可为客户提供半导体晶圆的研磨、抛光、减薄、划片、挑粒等主要业务,并能批量承接薄膜淀积、背面金属化等业务。

晶圆研磨 Wafer Grinding

晶圆减薄 Wafer Thinning

晶圆划片 Wafer Dicing

晶圆挑粒 Die picking & Placing

激光划片|切割|开槽
加工项目
特色项目
关键设备
典型客户
激光划片|切割|开槽
■ 激光隐形切割
Stealth Dicing(SD)
>> 激光器腔面镀膜陪条隐形切割
>> 热电堆红外传感器隐形切割
>> MEMS隐形切割
>> 激光反射器切割
■ 激光切割
Laser Dicing
>> 激光烧蚀(Ablation)划片
>> 异形芯片切割
>> 激光分切
■ 硅片激光开槽
Laser Grooving
■ 硅片打孔
Via Drilling
加工项目
| 加工项目 | 描述 | |
| 研磨倒角 | ■ 4~8 英寸硅材料片的研磨加工 ■ TTV<2 微米 ■ 一致性±2 微米 ■ 可加工1.5~6 英寸的硅片、蓝宝石、玻璃片、石英片的倒角 | |
| 晶圆减薄 | ■ 4~12英寸晶圆 ■ 背面研磨量产可以减到 100-150 微米厚度 ■ 非量产可背磨减薄到 30 微米厚度 ■ 磨轮从 320# 到 8000#可选 | |
| 晶圆划片 | ■ 提供刀片划片加工(Blade Dicing) ■ 提供激光划片加工(Laser Dicing or Stealth Dicing) ■ 12英寸以下各类硅片、石英、玻璃、陶瓷、氮化镓、PCB 基板、等产品的划片 ■ 8英寸以下晶圆的激光切割 | |
| 晶圆挑粒 | ■ 8 英寸以下各类晶圆的挑粒服务 | |
| 异形切割 | ■ 提供刀片或激光异形切割 ■ 提供晶圆各类分切加工 | |
特色项目
| 服务内容 | 描述 | |
| 超薄晶圆加工 | ■ 超薄晶圆减薄加工 ■ 硅片最薄可达30μm左右 ■ 砷化镓减薄后厚度可达100μm ■ 超薄晶圆加工可承接小批量和样品单 | |
| 激光切割加工 | ■ MEMS产品、RFID产品的激光隐形切割 ■ 边缘激光去环 ■ 激光分切 ■ 激光开槽 ■ 腔面镀膜陪条隐形切割 | |
| 单芯片研磨 | ■ 单颗芯片研磨及切割后研磨加工服务 ■ 可接单石英、PCB、陶瓷等研磨加工 | |
| MPW分切 | ■ 提供专业MPW多项目晶圆芯片的分切服务 ■ 提供专业的砷化镓切割服务,硅麦封装基板的切割,玻璃硅键合芯片的切割 ■ 提供不锈钢片、铜片、陶瓷片、石英片等特种材质基材的切割服务。 | |
| 砷化镓晶圆加工 | ■ 砷化镓晶圆的研磨减薄加工 ■ 砷化镓晶圆的抛光加工 ■ 砷化镓晶圆的切割加工 | |
关键设备
| 关键设备清单 | ||
| 设备名称 | 产地&品牌 | 数量 |
| 全自动磨片机 | 日本DISCO | 10 |
| 全自动切割机 | 日本DISCO | 30 |
| 自动挑粒机 | CETC 45所 | 5 |
| 激光切割机 | 日本DISCO | 1 |
典型客户
典型客户:
晶圆服务主要客户
- 无锡美新半导体(美资)、无锡中微晶圆、无锡中微爱芯、无锡华润微电子、杭州赛晶、苏州敏芯微、苏州吴江凤凰(韩资)等
- 中国电科24所、中国电科58所、中国电科49所等
- 无锡芯奥微传感技术、复旦微电子研究所等
- 北京大学、上海交通大学、浙江大学等
其它业务主要客户
- QFN:上海葵和精磨(AOS) 、无锡红光微
- MPW: 上海北芯、山东盛品、苏州美思迪赛
- 砷化镓:24所、国芯、中科海高
- PCB:无锡芯奥微传感技术、南通尚飞光电、苏州敏芯
- 激光切割:苏州敏芯、无锡芯奥微传感技术、南京晟芯
Services

SOI减薄
提供SOI衬底减薄、抛光加工服务,提供高达TTV>5um的超平SOI后加工服务。
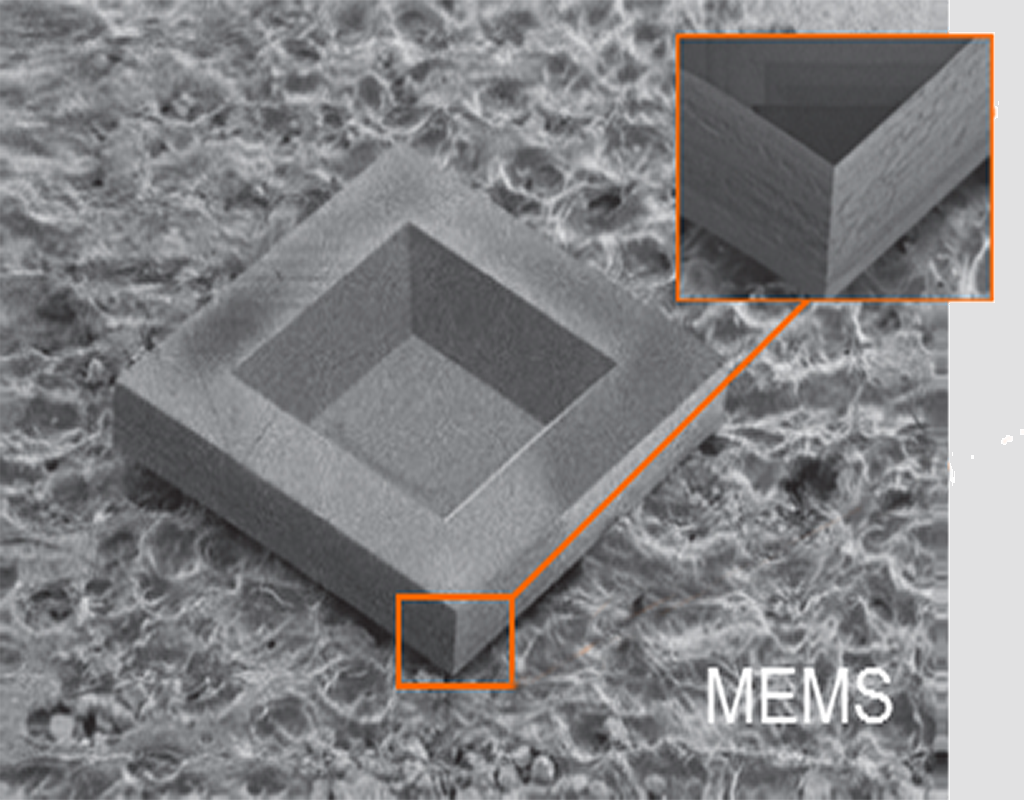
晶圆低温粒子键合
在真空环境中利用离子源清洁材料表面而形成强有力原子键合力的技术;适用于几乎所有材料的键合。
超薄加工
提供最薄达50um硅片的减薄、抛光加工,可以实现RTU开包即用的超净级(0.2um<20ea)包装。

精密刀片与激光划片
成熟的单刀、双刀划片工艺应对复杂的如GaN、GaAs类脆性材料;干法激光隐形切割提供无与伦比的窄划道与无污染工艺。
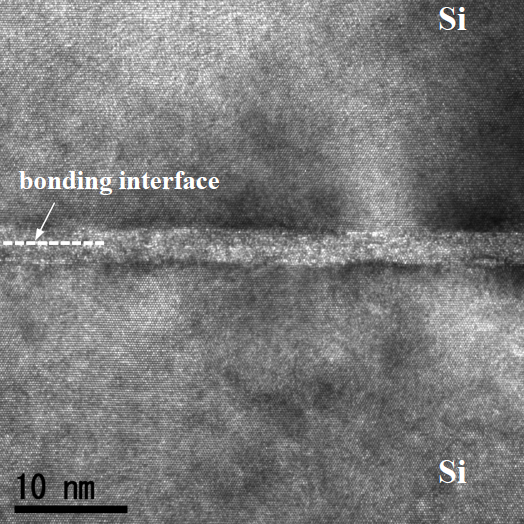
在线询价
电话&邮件询价
联系电话:18600564919
邮件:sales##innotronix.com.cn (用@替代##即可)