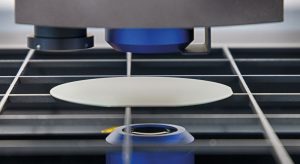

激光划片与激光隐形切割

什么是激光划片(Laser Ablation Dicing)?
将激光能量于极短的时间内集中在微小区域,使固体升华、蒸发的全切割加工,开槽加工方式,属于激光烧蚀加工技术(Laser Ablation Process)。
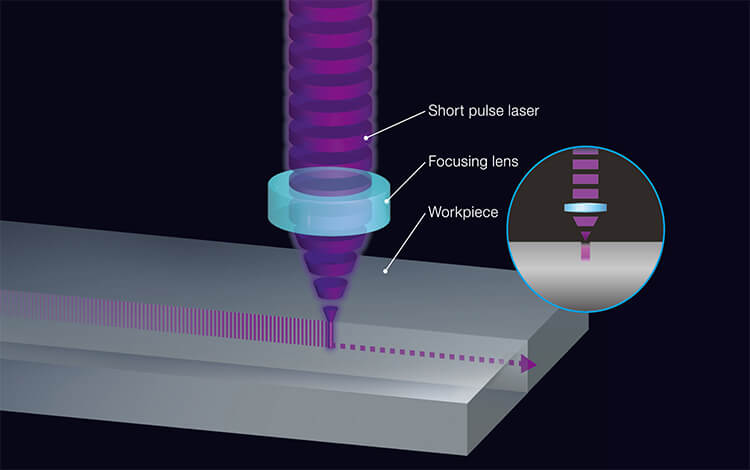
激光划片跟晶圆厚度有密切关系,厚度越厚,划片速度越慢,吞吐量就越低,下表提供了某一激光器划片速度的参考值。
晶圆厚度 | 参考切割速度 |
25μm | 2000mm/秒 |
50μm | 1000mm/秒 |
75μm | 600mm/秒 |
| 100μm | 375mm/秒 |
激光烧蚀划片适用于:
- 异形工件的切割加工
- 比较脆的材料的加工,比如砷化镓GaAs化合物半导体材料
- 超薄硅片的划片,避免传统刀片划片进给速度引发的破片风险
激光烧蚀划片的缺点:
- 激光烧蚀在表面会产生碎屑
- 需要额外的湿法清洗工序
- 有切割道
- 相对而言生产效率较低
什么是隐形切割(Stealth Dicing)?
隐形切割是由日本滨松(HAMAMATSU, www.hamamatsu.com.cn)公司发明,该技术将激光聚光于工件内部,在工件内部形成改质层,通过扩展胶膜等方法将工件分割成芯片的切割方法。
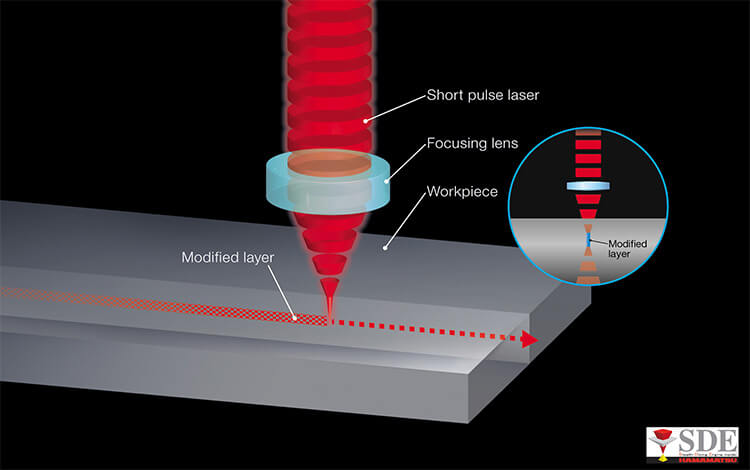
隐形切割的优点
- 由于工件内部改质,因此可以抑制加工屑的产生;适用于抗污垢性能差的工件
- 适用于抗负荷能力差的工件(MEMS等),且采用干式加工工艺,无需清洗
- 可以减小切割道宽度,因此有助于减小芯片间隔,适用于窄划道工件
激光隐形切割参考网站
激光隐形切割技术专题网站
https://sd.hamamatsu.com/jp/en/index.html
激光隐形切割的工艺流程
https://sd.hamamatsu.com/jp/en/SD_outline/SD_process.html
激光隐形切割与传统划片工艺对比
https://sd.hamamatsu.com/jp/en/SD_outline/SD_comparison.html
关于英创力科技
英创力科技可提供激光烧蚀加工、激光隐形切割的完备半导体工艺,广泛应用于VCSEL芯片、激光器芯片、MEMS芯片等产品的切割。
激光加工项目与服务能力
激光加工与激光切割
— 激光划片
— 激光分切
— 激光开槽
— 激光异形切割
— 激光钻孔
— 激光打码
激光隐形切割
— MEMS隐形切割
— 热堆红外传感器晶圆
— 硅麦晶圆隐形切割
— RFID隐形环切
